sekundäärinen IONIMASSASPEKTROMETRIA (SIMS) on herkin kaikista yleisesti käytetyistä pinta-analyyttisistä tekniikoista – se kykenee havaitsemaan pintakerroksessa olevat epäpuhtauselementit, joiden pitoisuus on < 1 ppm, ja epäpuhtauksien massapitoisuudet ovat suotuisissa tapauksissa noin 1 ppb (osa miljardia). Tämä johtuu massaspektrometrisiin tekniikoihin liittyvästä luontaisesta suuresta herkkyydestä.
tekniikasta on useita eri variantteja:
- Statics SIMS: käytetään yksikerroksiseen alkuaineanalyysiin
- Dynamic SIMS: käytetään koostumustietojen hankkimiseen pinnan alla olevan syvyyden funktiona
- kuvantaminen SIMS: käytetään spatiaalisesti ratkaistuun alkuaineanalyysiin
kaikki nämä tekniikan muunnelmat perustuvat samaan fysikaaliseen perusprosessiin, ja tätä prosessia käsitellään tässä yhdessä lyhyen johdannon kanssa staattisten simien alaan. Lisätietoja dynaamisista ja kuvantavista simeistä on kohdassa 7.4-SIMS-kuvantaminen ja Syvyysprofilointi.
Simsissä suurienergiset ionit pommittavat näytteen pintaa – Tämä johtaa sekä neutraalien että varautuneiden ( + / – ) lajien sinkoutumiseen (tai sputterointiin) pinnalta. Ulosheitetyt lajit voivat sisältää atomeja, atomirykelmiä ja molekyylikatkelmia.
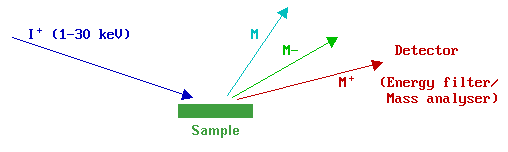
perinteisessä SIMS se on vain positiivisia ioneja, jotka massa analysoidaan – tämä on ensisijaisesti käytännön helppous, mutta se ei johda ongelmiin kvantifioimalla koostumustietoja, koska positiiviset ionit ovat vain pieni, ei-edustava osa koko sputteroitu lajeja. Siirtyneet ionit on tehokkaasti uutettava näytealueelta ja altistettava energiasuodatukselle ennen niiden massaanalyysiä (siten, että vain ionit, joilla on kineettistä energiaa rajoitetulla alueella, analysoidaan massasta).
massa-analysaattori voi olla kvadrupolin massa-analysaattori (yksikkömassan erottelukyvyllä), mutta usein käytetään myös magneettisektorin massa-analysaattoreita tai lentoajan analysaattoreita (TOF), jotka voivat tarjota huomattavasti suuremman herkkyyden ja massaresoluution sekä paljon suuremman massan alueen (vaikkakin suuremmilla kustannuksilla). Yleensä TOF-analysaattorit ovat suositeltavia staattisille simeille, kun taas quadrupole-ja magneettisektorin analysaattorit ovat suositeltavia dynaamisille simeille.
yleisimmin käytetyt näyteionit (jotka merkitään yllä olevassa kaaviossa I+: lla), joita käytetään näytteen pommittamiseen, ovat jalokaasuioneja (esim.Ar+), mutta joissakin sovelluksissa suositaan muita ioneja (esim. CS+, Ga+ tai O2+). TOF-Simsin avulla ensisijainen ionisäde pulssoidaan, jotta ionit hajoavat ajan kuluessa törmäyshetkestä, ja suuren massaresoluution saavuttamiseksi tarvitaan hyvin lyhyitä pulssin kestoja.
avustajat ja attribuutit
Roger Nix (Queen Mary, University of London)