La tecnica della Spettrometria di Massa di Ioni Secondari (SIMS) è il più sensibile di tutti comunemente impiegati superficie di tecniche analitiche in grado di rilevare impurità elementi presenti in uno strato di superficie a < 1 ppm di concentrazione e di massa concentrazioni di impurità di circa 1 ppb (part-per-miliardi di euro), in casi favorevoli. Ciò è dovuto all’elevata sensibilità intrinseca associata alle tecniche basate sulla spettrometria di massa.
Ci sono un certo numero di diverse varianti della tecnica :
- Statica dei SIMS: utilizzato per sub-monostrato analisi elementare
- Dinamico SIMS: utilizzato per ottenere informazioni sulla composizione in funzione della profondità sotto la superficie
- Imaging SIMS: utilizzato per spazialmente risolta analisi elementare
Tutte queste variazioni sulla tecnica sono basate sulla stessa base della fisica del processo, ed è questo processo che è discusso qui, insieme con una breve introduzione al campo statico di the SIMS. Ulteriori note sulle SIM dinamiche e di imaging possono essere ottenute nella Sezione 7.4-SIMS Imaging and Depth Profiling.
In SIMS la superficie del campione è sottoposta a bombardamento da ioni ad alta energia – questo porta all’espulsione (o sputtering) di specie sia neutre che cariche (+/-) dalla superficie. Le specie espulse possono includere atomi, gruppi di atomi e frammenti molecolari.
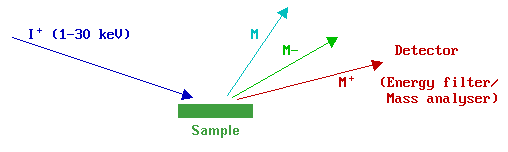
Nei SIM tradizionali sono solo gli ioni positivi che vengono analizzati in massa-questo è principalmente per facilità pratica, ma porta a problemi con la quantificazione dei dati compositivi poiché gli ioni positivi sono solo una piccola frazione non rappresentativa della specie totale sputtered. Gli ioni spostati devono essere estratti in modo efficiente dalla regione del campione e soggetti a filtraggio dell’energia prima di essere analizzati in massa (in modo che solo gli ioni con energie cinetiche all’interno di un intervallo limitato vengano analizzati in massa).
L’analizzatore di massa può essere un analizzatore di massa quadrupolo (con risoluzione di massa unitaria), ma vengono spesso utilizzati anche analizzatori di massa a settore magnetico o analizzatori di tempo di volo (TOF) che possono fornire una sensibilità e una risoluzione di massa sostanzialmente più elevate e un intervallo di massa molto maggiore (anche se a un costo In generale, gli analizzatori TOF sono preferiti per le SIM statiche, mentre gli analizzatori a quadrupolo e a settore magnetico sono preferiti per le SIM dinamiche.
Gli ioni incidente più comunemente impiegati (genericamente indicati con I+ nel diagramma precedente) utilizzati per bombardare il campione sono ioni di gas nobili (ad esempio Ar+ ) ma altri ioni (ad esempio Cs+, Ga+ o O2+ ) sono preferiti per alcune applicazioni. Con TOF-SIMS il fascio ionico primario viene pulsato per consentire agli ioni di essere dispersi nel tempo dall’istante dell’impatto e sono necessarie durate di impulsi molto brevi per ottenere un’elevata risoluzione di massa.
Contributori e attribuzioni
Roger Nix (Queen Mary, Università di Londra)