Die Technik der Sekundärionen-Massenspektrometrie (SIMS) ist die empfindlichste aller üblicherweise verwendeten Oberflächenanalysetechniken – in der Lage, in einer Oberflächenschicht vorhandene Verunreinigungselemente bei einer Konzentration von < 1 ppm und in günstigen Fällen Schüttkonzentrationen von Verunreinigungen von etwa 1 ppb (Teil pro Milliarde) nachzuweisen. Dies liegt an der inhärenten hohen Empfindlichkeit, die mit massenspektrometrischen Techniken verbunden ist.
Es gibt verschiedene Varianten der Technik :
- Statik-SIMS: wird für die Sub-Monolayer-Elementaranalyse verwendet
- Dynamische SIMS: wird verwendet, um Kompositionsinformationen als Funktion der Tiefe unter der Oberfläche zu erhalten
- Bildgebende SIMS: wird für die ortsaufgelöste Elementaranalyse verwendet
Alle diese Variationen der Technik basieren auf demselben grundlegenden physikalischen Prozess, und dieser Prozess wird hier zusammen mit einer kurzen Einführung in das Gebiet der statischen SIMS diskutiert. Weitere Hinweise zu dynamischen und bildgebenden SIMS finden Sie in Abschnitt 7.4 – SIMS-Bildgebung und Tiefenprofilierung.
In SIMS wird die Oberfläche der Probe einem Beschuss durch hochenergetische Ionen ausgesetzt – dies führt zum Ausstoßen (oder Sputtern) sowohl neutraler als auch geladener (+/-) Spezies von der Oberfläche. Die ausgestoßenen Spezies können Atome, Cluster von Atomen und Molekülfragmente umfassen.
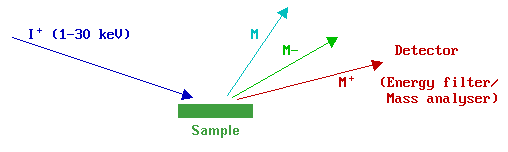
Bei herkömmlichen SIMS werden nur die positiven Ionen massenanalysiert – dies dient in erster Linie der praktischen Einfachheit, führt jedoch zu Problemen bei der Quantifizierung der Zusammensetzungsdaten, da die positiven Ionen nur ein kleiner, nicht repräsentativer Bruchteil der gesamten gesputterten Spezies sind. Die verdrängten Ionen müssen effizient aus dem Probenbereich extrahiert und einer Energiefilterung unterzogen werden, bevor sie massenanalysiert werden (so dass nur Ionen mit kinetischen Energien innerhalb eines begrenzten Bereichs massenanalysiert werden).
Der Massenanalysator kann ein Quadrupol-Massenanalysator (mit Masseneinheitsauflösung) sein, aber auch Magnetsektor-Massenanalysatoren oder TOF-Analysatoren (Time-of-Flight) werden häufig verwendet, und diese können eine wesentlich höhere Empfindlichkeit und Massenauflösung und einen viel größeren Massenbereich (wenn auch zu höheren Kosten) bereitstellen. Im Allgemeinen werden TOF-Analysatoren für statische SIMS bevorzugt, während Quadrupol- und Magnetsektoranalysatoren für dynamische SIMS bevorzugt werden.
Die am häufigsten verwendeten einfallenden Ionen (im obigen Diagramm generisch mit I + bezeichnet), die zum Beschuss der Probe verwendet werden, sind Edelgasionen (z. B. Ar +), aber andere Ionen (z. B. Cs +, Ga + oder O2 +) werden für einige Anwendungen bevorzugt. Bei TOF-SIMS wird der Primärionenstrahl gepulst, damit die Ionen ab dem Zeitpunkt des Aufpralls über die Zeit verteilt werden können, und es sind sehr kurze Pulsdauern erforderlich, um eine hohe Massenauflösung zu erhalten.
Mitwirkende und Zuschreibungen
Roger Nix (Queen Mary, University of London)