technika Spektrometrii Mas jonów wtórnych (SIMS) jest najbardziej czułą ze wszystkich powszechnie stosowanych technik analitycznych powierzchniowych-zdolnych do wykrywania elementów zanieczyszczeń obecnych w warstwie powierzchniowej przy stężeniu < 1 ppm i masowych stężeniach zanieczyszczeń około 1 ppb (część na miliard) w korzystnych przypadkach. Wynika to z wrodzonej wysokiej czułości związanej z technikami spektrometrycznymi mas.
istnieje wiele różnych wariantów tej techniki :
- statyka SIMS: używane do analizy pierwiastkowej sub-monowarstwowej
- dynamiczne SIMS: używane do uzyskiwania informacji kompozytowych w funkcji głębokości pod powierzchnią
- obrazowanie SIMS: używane do analizy pierwiastkowej przestrzennie rozdzielonej
wszystkie te odmiany techniki opierają się na tym samym podstawowym procesie fizycznym i jest to proces, który jest omawiany tutaj, wraz z krótkim wprowadzeniem do dziedziny statyki Sims. Dalsze uwagi na temat dynamicznych i obrazujących Simów można uzyskać w sekcji 7.4-obrazowanie SIMS i profilowanie głębokości.
w SIMS powierzchnia próbki jest poddawana bombardowaniu jonami o wysokiej energii – prowadzi to do wyrzucania (lub rozpylania) zarówno neutralnych, jak i naładowanych (+/-) gatunków z powierzchni. Wyrzucane gatunki mogą obejmować Atomy, skupiska atomów i fragmenty molekularne.
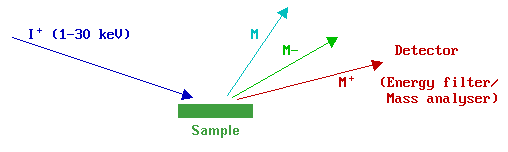
w tradycyjnych Simów analizuje się masę tylko jonów dodatnich – jest to przede wszystkim dla praktycznej łatwości, ale prowadzi to do problemów z kwantyfikacją danych dotyczących składu, ponieważ jony dodatnie są tylko niewielką, niereprezentatywną frakcją wszystkich rozpylonych gatunków. Przemieszczone jony muszą być skutecznie ekstrahowane z obszaru próbki i poddawane filtracji energetycznej, zanim zostaną poddane analizie masy (tak, że tylko jony o energiach kinetycznych w ograniczonym zakresie są analizowane masowo).
analizator masy może być kwadratowym analizatorem masy (z jednostkową rozdzielczością masy), ale często stosuje się również analizatory masy sektora magnetycznego lub analizatory czasu lotu (TOF), które mogą zapewnić znacznie wyższą czułość i rozdzielczość masy oraz znacznie większy zakres masy (choć przy wyższych kosztach). Ogólnie rzecz biorąc, analizatory TOF są preferowane dla statycznych SIM, podczas gdy analizatory sektora kwadrupolowego i magnetycznego są preferowane dla dynamicznych SIM.
najczęściej stosowanymi jonami incydentalnymi (ogólnie oznaczonymi przez I+ na powyższym schemacie) używanymi do bombardowania próbki są jony gazu szlachetnego (np. Ar+), ale inne jony (np. Cs+, Ga+ lub O2+ ) są preferowane w niektórych zastosowaniach. Dzięki TOF-SIMS pierwotna wiązka jonów jest pulsowana, aby umożliwić rozproszenie jonów w czasie od momentu uderzenia, a bardzo krótkie czasy trwania impulsu są wymagane do uzyskania wysokiej rozdzielczości masy.
autorzy i atrybuty
Roger Nix (Queen Mary, University of London)