a szekunder Ion tömegspektrometria (SIMS) technikája a legérzékenyebb az összes általánosan alkalmazott felületanalitikai technika közül-képes kimutatni a felületi rétegben lévő szennyező elemeket < 1 ppm koncentrációban, és kedvező esetekben a szennyeződések ömlesztett koncentrációja körülbelül 1 ppb (milliárd rész). Ennek oka a benne rejlő nagy érzékenység tömegspektrometrián alapuló technikák.
a technika számos különböző változata létezik:
- Statics SIMS: sub-monolayer elemental analysis
- Dynamic SIMS: a felszín alatti mélység függvényében összetételi információk megszerzésére szolgál
- Imaging SIMS: térben feloldott elemanalízishez
a technika ezen variációi ugyanazon az alapvető fizikai folyamaton alapulnak, és ezt a folyamatot tárgyaljuk itt, a statikus simek területének rövid bemutatásával együtt. További megjegyzések a dinamikus és képalkotó SIM – ekről a 7.4-SIMS Imaging and Depth Profiling szakaszban találhatók.
a SIMS-ben a minta felületét nagy energiájú ionok bombázzák – ez mind a semleges, mind a töltött ( + / – ) Fajok kilökődéséhez (vagy porlasztásához) vezet a felszínről. A kilökődő fajok közé tartozhatnak atomok, atomcsoportok és molekuláris fragmensek.
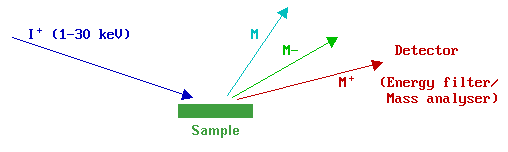
a hagyományos SIM-ekben csak a pozitív ionokat elemzik tömegesen-ez elsősorban a gyakorlati könnyedség érdekében, de problémákhoz vezet a kompozíciós adatok számszerűsítésével, mivel a pozitív ionok csak kicsiek, az összes porlasztott faj nem reprezentatív hányada. A kiszorított ionokat hatékonyan kell kivonni a mintarégióból, és energiaszűrésnek kell alávetni, mielőtt tömegelemzést végeznének (így csak a korlátozott tartományon belüli kinetikus energiájú ionok kerülnek tömegelemzésre).
a tömeganalizátor lehet kvadrupol tömeganalizátor (egység tömegfelbontással), de gyakran használnak mágneses szektor tömeganalizátorokat vagy repülési idő (TOF) analizátorokat is, amelyek lényegesen nagyobb érzékenységet és tömegfelbontást, valamint sokkal nagyobb tömegtartományt biztosítanak (bár magasabb költséggel). Általában a TOF analizátorokat részesítik előnyben a statikus SIM-eknél,míg a quadrupole és a mágneses szektor analizátorokat a dinamikus SIM-eknél.
a minta bombázására leggyakrabban használt beeső ionok (amelyeket a fenti ábrán általában I+ jelöl) a nemesgáz ionok (például Ar+), de más ionok (például Cs+, Ga+ vagy O2+ ) előnyösek egyes alkalmazásoknál. A TOF-SIMS-szel az elsődleges ionnyaláb pulzálódik, hogy lehetővé tegye az ionok diszpergálását az ütközés pillanatától kezdve, és nagyon rövid impulzusidőtartamokra van szükség a nagy tömegfelbontás eléréséhez.
közreműködők és nevezések
Roger Nix (Queen Mary, University of London)