二次イオン質量分析(SIMS)の技術は、一般的に使用されているすべての表面分析技術の中で最も高感度であり、<1ppm濃度で表面層に存在する不純物元素を検出することができ、好ましい場合には1ppb(億分の一)程度の不純物のバルク濃度を検出することができる。 これは質量分析計ベースの技術と関連付けられる固有の高い感受性のためにある。
この手法にはいくつかの異なる変種があります:
- 静的SIMS:サブ単分子層元素分析に使用
- 動的SIMS:表面の下の深さの関数として組成情報を取得するために使用
- イメージングSIMS:空間分解元素分析に使用
技術上のこれらのバリエーションはすべて同じ基本的な物理的プロセスに基づいており、ここで説明するのはこのプロセスであり、静的SIMSの分野の簡単な紹介と一緒に説明されている。 ダイナミックSIMとイメージングSIMに関するさらなる注意事項は、セクション7.4-SIMSイメージングと深さプロファイリングで得ることができます。
SIMSでは、試料の表面は高エネルギーイオンによる衝撃を受け、これにより表面から中性および荷電(+/-)種の両方が放出(またはスパッタリング)される。 放出された種は、原子、原子のクラスターおよび分子断片を含むことができる。
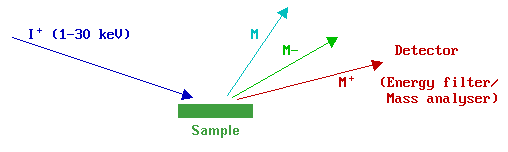
従来のSIMSでは、質量分析されるのは正イオンのみです-これは主に実用的な容易さのためですが、正イオンはスパッタされた全種の小さな非代表的な画分であるため、組成データを定量化する際に問題が発生します。 変位したイオンは、質量分析される前に、サンプル領域から効率的に抽出され、エネルギーフィルタリングされなければならない(限られた範囲内の運動エネルギーを有するイオンのみが質量分析されるように)。
質量分析装置は四重極質量分析装置(単位質量分解能を有する)であってもよいが、磁気セクタ質量分析装置または飛行時間(TOF)分析装置もよく使用され、これらは実質的に高い感度および質量分解能を提供し、はるかに大きな質量範囲を提供することができる(より高いコストではあるが)。 一般に、TOFの検光子は静的なSIMSのために好まれ、四重極および磁気セクターの検光子は動的SIMSのために好まれます。
サンプルの衝撃に使用される最も一般的に使用される入射イオン(上の図では一般的にI+で示される)は希ガスイオン(例えばAr+)であるが、他のイオン(例えばCs+、Ga+またはO2+)がいくつかの用途に好ましい。 TOF-SIMSでは、一次イオンビームをパルス化して、衝撃の瞬間から時間の経過とともにイオンを分散させることができ、高い質量分解能を得るためには非常に短いパルス持続時間が必要である。
貢献者と帰属
Roger Nix(Queen Mary,University of London)