teknikken til sekundær Ionmassespektrometri (SIMS) er den mest følsomme af alle de almindeligt anvendte overfladeanalyseteknikker-i stand til at detektere urenhedselementer, der er til stede i et overfladelag ved < 1 ppm koncentration, og bulkkoncentrationer af urenheder på omkring 1 ppb (del – per-milliard) i gunstige tilfælde. Dette skyldes den iboende høje følsomhed forbundet med massespektrometrisk-baserede teknikker.
der er en række forskellige varianter af teknikken :
- statik SIMS: bruges til submonolag elementanalyse
- dynamiske SIMS: bruges til at opnå kompositionsinformation som en funktion af dybden under overfladen
- Imaging SIMS: bruges til rumligt løst elementanalyse
alle disse variationer på teknikken er baseret på den samme grundlæggende fysiske proces, og det er denne proces, der diskuteres her sammen med en kort introduktion til området statiske SIMS. Yderligere noter om dynamiske og billeddannende SIM ‘ er kan fås i afsnit 7.4 – SIMS billeddannelse og Dybdeprofilering.
i SIMS udsættes overfladen af prøven for bombardement af ioner med høj energi – dette fører til udstødning (eller forstøvning) af både neutrale og ladede (+/-) arter fra overfladen. De udstødte arter kan omfatte atomer, klynger af atomer og molekylære fragmenter.
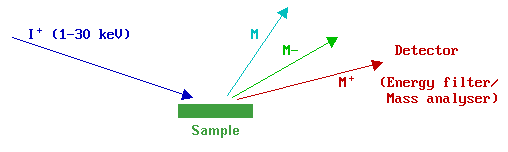
i traditionelle simmere er det kun de positive ioner, der masseanalyseres – dette er primært for praktisk lethed, men det fører til problemer med at kvantificere sammensætningsdataene, da de positive ioner kun er en lille, ikke-repræsentativ brøkdel af den samlede sputterede Art. De fordrevne ioner skal ekstraheres effektivt fra prøveområdet og underkastes energifiltrering, før de masseanalyseres (således at kun ioner med kinetiske energier inden for et begrænset område masseanalyseres).
masseanalysatoren kan være en kvadrupol masseanalysator (med enhedsmasseopløsning), men magnetiske sektormasseanalysatorer eller time-of-flight (TOF) analysatorer bruges også ofte, og disse kan give væsentligt højere følsomhed og masseopløsning og et meget større masseområde (omend til en højere pris). Generelt foretrækkes TOF-analysatorer til statiske SIM ‘er, mens firpol-og magnetiske sektoranalysatorer foretrækkes til dynamiske SIM’ er.
de hyppigst anvendte hændelsesioner (generisk betegnet med I+ i ovenstående diagram), der anvendes til bombardering af prøven, er ædelgasioner (f.eks. Ar+), men andre ioner (f. eks. Cs+, Ga+ eller O2+ ) foretrækkes til nogle applikationer. Med TOF-SIMS pulseres den primære ionstråle for at gøre det muligt for ionerne at blive spredt over tid fra påvirkningsøjeblikket, og der kræves meget korte pulsvarigheder for at opnå høj masseopløsning.
bidragydere og tilskrivninger
Roger (Dronning Mary, University of London)