La technique de Spectrométrie de masse d’ions secondaires (SIMS) est la plus sensible de toutes les techniques d’analyse de surface couramment utilisées – capable de détecter les éléments d’impureté présents dans une couche de surface à une concentration < 1 ppm, et des concentrations en vrac d’impuretés d’environ 1 ppb (partie par milliard) dans des cas favorables. Cela est dû à la sensibilité élevée inhérente associée aux techniques basées sur la spectrométrie de masse.
Il existe un certain nombre de variantes différentes de la technique :
- SIMS statiques: utilisé pour l’analyse élémentaire sous-monocouche
- SIMS dynamiques: utilisé pour obtenir des informations de composition en fonction de la profondeur sous la surface
- SIMS d’imagerie: utilisé pour l’analyse élémentaire à résolution spatiale
Toutes ces variations de la technique sont basées sur le même processus physique de base et c’est ce processus qui est discuté ici, avec une brève introduction au domaine des SIMS statiques. D’autres notes sur les SIM dynamiques et d’imagerie peuvent être obtenues dans la section 7.4 – Imagerie SIMS et profilage de profondeur.
Dans SIMS, la surface de l’échantillon est soumise à un bombardement par des ions à haute énergie, ce qui entraîne l’éjection (ou la pulvérisation) d’espèces neutres et chargées (+/-) de la surface. Les espèces éjectées peuvent comprendre des atomes, des amas d’atomes et des fragments moléculaires.
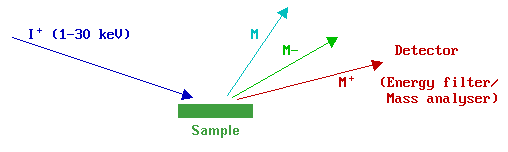
Dans les SIM traditionnels, seuls les ions positifs sont analysés en masse – c’est principalement pour faciliter la tâche, mais cela pose des problèmes de quantification des données de composition, car les ions positifs ne sont qu’une petite fraction non représentative de l’espèce totale pulvérisée. Les ions déplacés doivent être efficacement extraits de la région de l’échantillon et soumis à un filtrage d’énergie avant d’être analysés en masse (de sorte que seuls les ions ayant des énergies cinétiques dans une plage limitée sont analysés en masse).
L’analyseur de masse peut être un analyseur de masse quadripolaire (avec une résolution de masse unitaire), mais des analyseurs de masse à secteur magnétique ou des analyseurs de temps de vol (TOF) sont également souvent utilisés et peuvent fournir une sensibilité et une résolution de masse sensiblement plus élevées, et une plage de masse beaucoup plus grande (bien qu’à un coût plus élevé). En général, les analyseurs TOF sont préférés pour les SIM statiques, tandis que les analyseurs quadripolaires et à secteurs magnétiques sont préférés pour les SIM dynamiques.
Les ions incidents les plus couramment utilisés (désignés génériquement par I + dans le diagramme ci-dessus) utilisés pour bombarder l’échantillon sont des ions de gaz noble (par exemple Ar +) mais d’autres ions (par exemple Cs +, Ga + ou O2 +) sont préférés pour certaines applications. Avec TOF-SIMS, le faisceau d’ions primaire est pulsé pour permettre la dispersion des ions dans le temps à partir de l’instant de l’impact, et des durées d’impulsions très courtes sont nécessaires pour obtenir une résolution de masse élevée.
Contributeurs et attributions
Roger Nix (Queen Mary, Université de Londres)