de techniek van de secundaire Ionenmassaspectrometrie (SIMS) is de meest gevoelige van alle gangbare oppervlakteanalysetechnieken-die in staat zijn onzuiverheden die in een oppervlaktelaag aanwezig zijn bij een concentratie < 1 ppm, en bulkconcentraties van onzuiverheden van ongeveer 1 ppb (deel – per-miljard) in gunstige gevallen te detecteren. Dit is wegens de inherente hoge gevoeligheid verbonden aan massaspectrometrische-gebaseerde technieken.
er zijn een aantal verschillende varianten van de techniek :
- Statics SIMS: used for sub-monolayer elemental analysis
- Dynamic SIMS: used for receiving compositional information as a function of depth below the surface
- Imaging SIMS: used for spatial-resolved elemental analysis
al deze variaties op de techniek zijn gebaseerd op hetzelfde fysische basisproces en dit proces wordt hier besproken, samen met een korte inleiding op het gebied van statische SIMS. Verdere opmerkingen over dynamische en imaging SIMS kunnen worden verkregen in Paragraaf 7.4 – Sims Imaging and Depth Profiling.
in SIMS wordt het oppervlak van het monster gebombardeerd met ionen met hoge energie – dit leidt tot het uitwerpen (of sputteren) van zowel neutrale als geladen (+/-) soorten van het oppervlak. De uitgeworpen species kunnen atomen, clusters van atomen en moleculaire fragmenten omvatten.
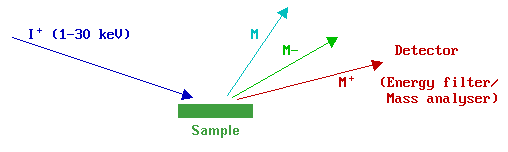
in traditionele SIMS zijn het alleen de positieve ionen die massa worden geanalyseerd – dit is in de eerste plaats voor praktisch gemak, maar het leidt tot problemen met het kwantificeren van de samenstellingsgegevens aangezien de positieve ionen slechts een kleine, niet-representatieve fractie van de totale gesputterde soorten zijn. De verplaatste ionen moeten efficiënt uit het monstergebied worden gehaald en aan energie-filtering worden onderworpen alvorens zij massa worden geanalyseerd (zodat alleen ionen met kinetische energieën binnen een beperkt bereik massa worden geanalyseerd).
de massaanalysator kan een quadrupole-massaanalysator zijn( met eenheidsmassa-resolutie), maar magnetische sector-massaanalyzers of Time-of-flight (TOF) – analyzers worden ook vaak gebruikt en deze kunnen een aanzienlijk hogere gevoeligheid en massa-resolutie bieden, en een veel groter massabereik (zij het tegen hogere kosten). In het algemeen hebben TOF analyzers de voorkeur voor statische SIMS, terwijl quadrupole en magnetische sector analyzers de voorkeur hebben voor dynamische SIMS.
de meest gebruikte invallende ionen (in het bovenstaande diagram in het algemeen aangeduid met I+) die worden gebruikt om het monster te bombarderen, zijn edelgasionen (bv. Ar+), maar andere ionen (bv. Cs+, Ga+ of O2+ ) hebben voor sommige toepassingen de voorkeur. Met TOF-SIMS wordt de primaire ionenbundel gepulseerd zodat de ionen vanaf het moment van de botsing in de tijd kunnen worden verspreid, en zijn zeer korte pulsduur vereist om een hoge massaresolutie te verkrijgen.
bijdragers en toeschrijvingen
Roger Nix (Queen Mary, University of London)