tekniken för sekundär Jonmasspektrometri (SIMS) är den mest känsliga av alla de allmänt använda ytanalysteknikerna-som kan detektera orenhetselement närvarande i ett ytskikt vid < 1 ppm – koncentration och bulkkoncentrationer av föroreningar på cirka 1 ppb (del per miljard) i gynnsamma fall. Detta beror på den inneboende höga känsligheten associerad med masspektrometribaserade tekniker.
det finns ett antal olika varianter av tekniken :
- Statics SIMS: används för sub-monolayer elementär analys
- dynamiska SIMS: används för att erhålla kompositionsinformation som en funktion av djup under ytan
- Imaging SIMS: används för rumsligt löst elementär analys
alla dessa variationer på tekniken är baserade på samma grundläggande fysiska process och det är denna process som diskuteras här, tillsammans med en kort introduktion till området statiska SIMS. Ytterligare anteckningar om dynamiska och avbildande simmar kan erhållas i avsnitt 7.4-SIMS avbildning och Djupprofilering.
i SIMS utsätts provets yta för bombardemang av högenergijoner – detta leder till utstötning (eller sputtering) av både neutrala och laddade (+/-) arter från ytan. De utstötta arterna kan innefatta atomer, kluster av atomer och molekylära fragment.
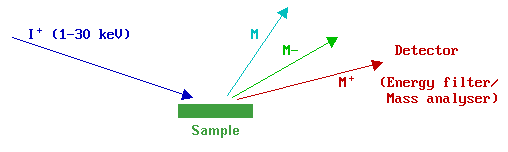
i traditionella simmar är det bara de positiva jonerna som massanalyseras – detta är främst för praktisk lätthet men det leder till problem med att kvantifiera kompositionsdata eftersom de positiva jonerna bara är en liten, icke-representativ bråkdel av den totala sputterade arten. De förskjutna jonerna måste effektivt extraheras från provregionen och underkastas energifiltrering innan de analyseras massa (så att endast joner med kinetiska energier inom ett begränsat område analyseras massa).
massanalysatorn kan vara en quadrupolmassanalysator (med enhetsmassupplösning), men magnetiska sektormassanalysatorer eller time-of-flight (TOF) analysatorer används också ofta och dessa kan ge väsentligt högre känslighet och massupplösning och ett mycket större massområde (om än till en högre kostnad). I allmänhet föredras TOF-analysatorer för statiska simmar, medan quadrupol-och magnetiska sektoranalysatorer föredras för dynamiska simmar.
de vanligaste använda infallande jonerna (generiskt betecknade med I+ i ovanstående diagram) som används för att bombardera provet är ädelgasjoner (t.ex. Ar+ ) men andra joner (t. ex. Cs+, Ga+ eller O2+ ) föredras för vissa applikationer. Med TOF-SIMS pulseras den primära jonstrålen för att göra det möjligt för jonerna att spridas över tiden från ögonblicket av påverkan, och mycket korta pulslängder krävs för att erhålla hög massupplösning.
bidragsgivare och attribut
Roger Nix (Queen Mary, University of London)