A técnica de Secundário de Iões de Espectrometria de Massa (SIMS) é o mais sensível de todos os comumente empregados superfície técnicas analíticas – capaz de detectar a impureza elementos presentes em uma camada de superfície em < 1 ppm de concentração, em massa e concentrações de impurezas na ordem de 1 ppb (parte por bilhão) em casos favoráveis. Isto deve-se à elevada sensibilidade inerente associada a técnicas baseadas em espectrometria de massa.
Há um número de diferentes variantes da técnica :
- Estatísticas SIMS: usado para a sub-camada única análise elementar
- Dinâmica SIMS: usado para a obtenção de informações de composição como uma função da profundidade abaixo da superfície
- Imagem SIMS: usado para espacialmente resolvidos análise elementar
Todas essas variações sobre a técnica são baseadas no mesmo processo físico básico e é este processo que é discutido aqui, juntamente com uma breve introdução ao campo da estática SIMS. Podem ser obtidas outras notas sobre SIMS dinâmicos e imagiológicos na Secção 7.4 – Sims Imaging and Depth Profiling.
em SIMS, A superfície da amostra é submetida a bombardeamento por iões de alta energia – o que leva à ejecção (ou sputtering) de espécies neutras e carregadas (+/-) da superfície. As espécies ejetadas podem incluir átomos, aglomerados de átomos e fragmentos moleculares.
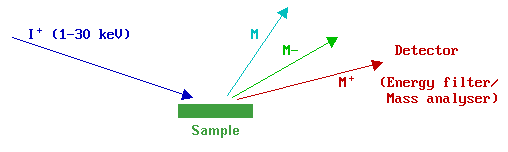
em SIMS tradicionais são apenas os íons positivos que são analisados em massa-isso é principalmente para facilidade prática, mas leva a problemas com a quantificação dos dados de composição, uma vez que os íons positivos são apenas uma pequena fração não representativa da espécie total pulverizada. Os íons deslocados têm que ser eficientemente extraídos da região da amostra e sujeitos a filtragem de energia antes de serem analisados em massa (de modo que apenas íons com energias cinéticas dentro de uma faixa limitada são analisados em massa).
o analisador de massa pode ser um analisador de massa quadrúpede (com resolução de massa unitária), mas analisadores de massa do setor magnético ou analisadores de tempo de voo (TOF) também são frequentemente utilizados e estes podem fornecer sensibilidade e resolução de massa substancialmente mais elevadas, e uma gama de massa muito maior (embora a um custo mais elevado). Em geral, analisadores TOF são preferidos para SIMS estáticos, enquanto analisadores quadrupol e setor magnético são preferidos para SIMS dinâmicos.
os iões incidentes mais frequentemente utilizados (geralmente denotados por i+ no diagrama acima) utilizados para bombardear a amostra são iões de gases nobres (por exemplo, Ar+), mas outros iões (por exemplo, Cs+, Ga+ ou O2+ ) são preferidos para algumas aplicações. Com TOF-SIMS, o feixe de íons primário é pulsado para permitir que os íons sejam dispersos ao longo do tempo a partir do momento do impacto, e são necessárias durações de pulso muito curtas para obter alta resolução de massa.
contribuidores e atribuições
Roger Nix (Queen Mary, University of London)