teknikken For Sekundær Ion Massespektrometri (SIMS) er den mest følsomme av ALLE de vanlige anvendte overflateanalytiske teknikkene-i stand til å oppdage urenhetselementer som er tilstede i et overflatelag ved < 1 ppm konsentrasjon, og bulkkonsentrasjoner av urenheter på rundt 1 ppb (del per milliard) i gunstige tilfeller. Dette skyldes den iboende høye følsomheten forbundet med massespektrometriske baserte teknikker.
det finnes en rekke forskjellige varianter av teknikken :
- Statikk SIMS: brukes til sub-monolayer elementanalyse
- Dynamiske SIMS: brukes til å skaffe komposisjonsinformasjon som en funksjon av dybde under overflaten
- Imaging SIMS: brukes til romlig løst elementanalyse
Alle disse variasjonene på teknikken er basert på den samme grunnleggende fysiske prosessen, og det er denne prosessen som diskuteres her, sammen med en kort introduksjon til feltet statiske SIMS. Ytterligere notater om dynamiske OG bildediagnostiske SIMMER kan fås i Avsnitt 7.4-SIMS Imaging and Depth Profiling.
i SIMS overflaten av prøven blir utsatt for bombardement av høy energi ioner-dette fører til utstøting (eller sputtering) av både nøytrale og ladede ( + / – ) arter fra overflaten. De utkastede artene kan omfatte atomer, klynger av atomer og molekylære fragmenter.
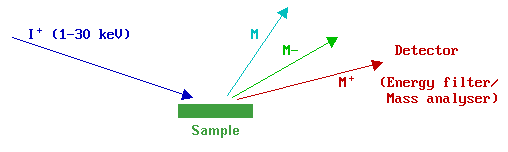
i tradisjonelle SIMS er det bare de positive ionene som masseanalyseres – dette er først og fremst for praktisk letthet, men det fører til problemer med å kvantifisere komposisjonsdataene siden de positive ionene bare er en liten, ikke-representativ brøkdel av den totale sputterte arten. De fordrevne ionene må effektivt ekstraheres fra prøveområdet og underkastes energifiltrering før de masseanalyseres (slik at bare ioner med kinetiske energier innenfor et begrenset område blir masseanalysert).
masseanalysatoren kan være en quadrupole masseanalysator (med enhetsmasseoppløsning), men magnetiske sektormasseanalysatorer eller tof-analysatorer brukes også ofte, og disse kan gi vesentlig høyere følsomhet og masseoppløsning og et mye større masseområde (om enn til en høyere kostnad). GENERELT ER TOF-analysatorer foretrukket for statiske SIMMER, mens quadrupole og magnetiske sektoranalysatorer foretrekkes for dynamiske SIMMER.
de mest brukte hendelsesionene (generelt betegnet med I+ i diagrammet ovenfor) som brukes til å bombardere prøven, er edelgassioner (F. eks. Ar+), men andre ioner (F. Eks. Cs+, Ga+ eller O2+ ) foretrekkes for noen applikasjoner. Med TOF-SIMS pulseres den primære ionstrålen for å gjøre det mulig for ionene å bli spredt over tid fra øyeblikket av støt, og svært korte pulsvarigheter kreves for å oppnå høy masseoppløsning.
Bidragsytere Og Attribusjoner
Roger Nix (Queen Mary, University Of London)